
简介
该用户还未填写简介
擅长的技术栈
未填写擅长的技术栈
可提供的服务
暂无可提供的服务
EDA开发之芯片行业名词解释(5)
需要注意的是,并行计算并不总是带来线性的性能提升。实际性能提升取决于多种因素,包括数据集大小、维度、硬件架构、线程/核心数量、内存访问模式、算法本身的并行性等。此外,引入并行化可能会增加代码的复杂性,并需要仔细处理并行化带来的同步和通信开销。它包含了一系列针对大数据集和高维度特征的算法,用于快速查找数据集中的近似最近邻。需要注意的是,虽然FLANN提供了快速的近似最近邻搜索,但它并不保证找到的确切
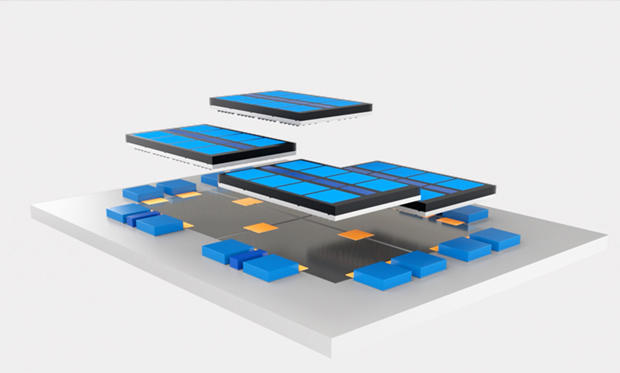
EDA开发之芯片行业名词解释(2)
在电路板设计中,通常使用的标准方形孔尺寸为0.3mm x 0.3mm、0.4mm x 0.4mm、0.5mm x 0.5mm、0.6mm x 0.6mm、0.7mm x 0.7mm、0.8mm x 0.8mm、0.9mm x 0.9mm、1.0mm x 1.0mm等。仿真结果可以帮助他们识别系统中的功率损失瓶颈,并采取相应的优化措施,如改进布线设计、优化开关元件的选择、调整磁性元件的规格等,以降低
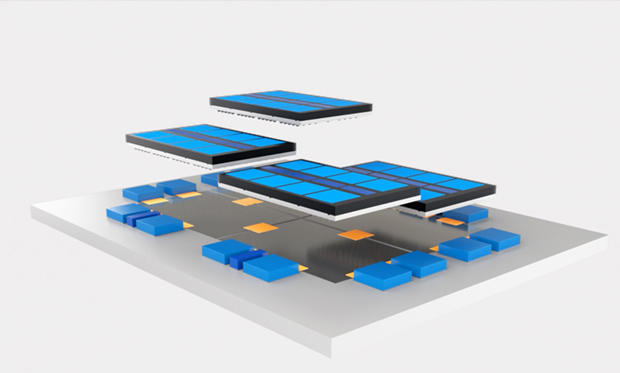
Dummy Die(模拟芯片或虚拟芯片)
Dummy Die(模拟芯片或虚拟芯片)在半导体制造和电路设计中起着多个重要作用。
热沉(Heat Sink Materials)和TIM热界面材料(Thermal Interface Materials, TIM)
热沉(Heat Sink Materials)和TIM热界面材料(Thermal Interface Materials, TIM)在电子封装领域各自扮演着重要的角色,它们在功能、应用以及特性上存在显著的区别。

到底了










