
简介
该用户还未填写简介
擅长的技术栈
可提供的服务
暂无可提供的服务
Machine Learning-Based Modeling and BV Optimization for LDMOS With Multifloating Buried Layers(TED 25年)

提出了一种精确基于物理的解析模型,用于描述p-GaN栅AlGaN/GaN高电子迁移率晶体管(HEMT)的栅电容。该模型在形成泊松方程时考虑了p-GaN帽层中受主的不完全离子化以及Mg受主向AlGaN势垒层的外扩散,该方程与AlGaN/GaN量子阱中的电荷方程一起求解。该模型在宽偏置范围内得到了验证,与实验结果显示出良好的一致性。还使用该模型分析了单个设备参数对电容-电压(C-V)特性的影响。此外还
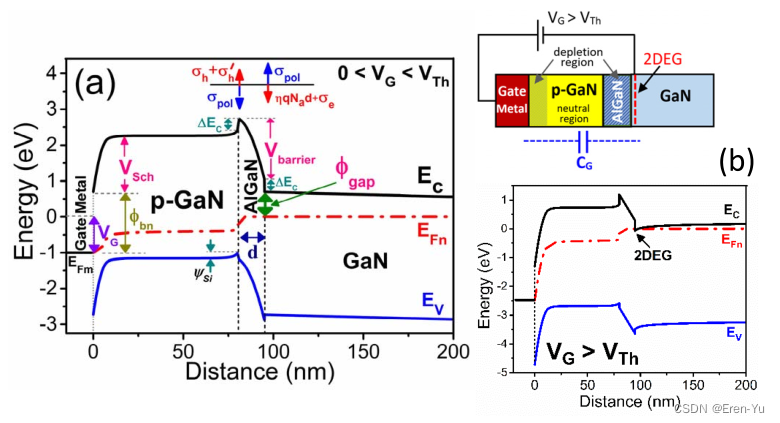
在过去的几十年里,使用数值方法进行SPICE建模或对现有SPICE模型参数进行表征(提取)的提交论文数量显著增加。许多此类文章依赖于合成数据——这些数据或通过技术计算机辅助设计(TCAD)生成,或基于物理SPICE模型的仿真结果;而大多数并未对实测数据进行建模/拟合。此外,这些文章未对其提出的数值方法的物理正确性、平滑性/单调性或渐近正确性进行评估。尽管这种方法足以对技术进行初步验证,但无法证明其

摘要 - 针对AlGaN/GaN HFET,提出了一种无拟合参数的物理解析模型。对于非饱和操作,建立了两个接入区和栅极下方I-V特性的非线性分析模型。所得方程通过边界处的电压和电流连续性连接在一起。证明了该模型与商业模拟器ATLAS的相应模拟之间的良好一致性。此外,所提出的模型与流行的HFET操作曲线拟合模型相比是有利的。索引术语 - HEMT,建模,电阻。
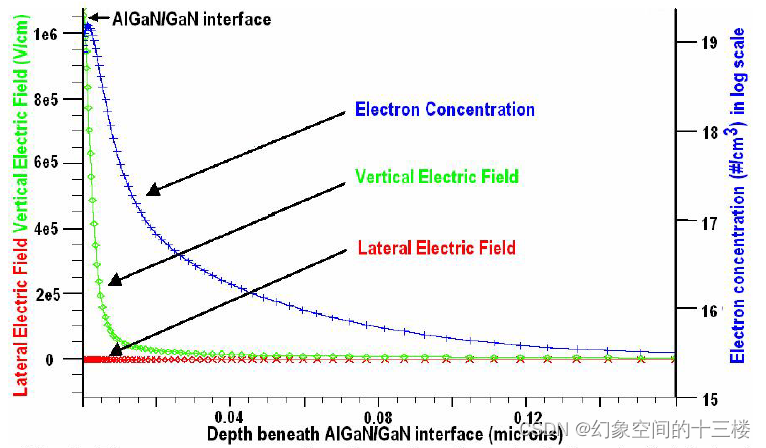
在SiC功率半导体器件的封装中,一般采用的封装形式包括TO封装、DIP封装、SMD封装、QFN封装等。其中,TO封装是一种常见的封装形式,它具有良好的散热性能,适用于高功率的应用场合。DIP封装和SMD封装则更适用于中低功率的应用场合,同时具有较小的尺寸和较低的成本。QFN封装则是一种新型的封装形式,其具有较小的尺寸和良好的散热性能,适用于高密度的应用场合。常见的封装材料包括铝、铜、银、金等,其中
GaN RF提取项目提供了一个初始的提取示例流程,以便您可以了解GaN模型的提取。这些项目和工具具有灵活性,可以轻松自定义以实现特定工艺技术的最佳准确性。提取流程是一个逐步手动过程,需要对模型及其参数有一定的了解。准备设置并加载测量数据。通过设置一些重要的变量(名称、工作目录等)来定义项目。初始化参数,包括已知的工艺和布局信息。执行逐步提取(这取决于模型)。最后,保存结果。IC-CAP软件学习交流
使用 TCAD 提取的 I-V 和 C-V 曲线族,结合 Keysight 的 IC-CAP 器件建模套件和先进SPICE模型用于高电子迁移率晶体管 (ASMHEMT) 模型卡,提取 HEMT 模型卡。此外,模型卡提取的 S 参数也与 TCAD 提取的 S 参数相匹配。完成直流、C-V 和 S 参数匹配后,使用 Keysight 的 Advanced Design System (ADS) 对工作

对于增强型GaN功率晶体管的发展,栅压摆幅和阈值电压稳定性通常是互相排斥的。本文展示了一种具有内置p-GaN电位稳定器(PPS)的金属/绝缘体/p-GaN栅极高电子迁移率晶体管(MIP-HEMT),能够同时实现大的栅压摆幅和增强的阈值电压稳定性。MIP栅结构将栅压摆幅扩大到19.5V,并作为一个交流耦合电容器(常用于栅驱动器中,以加快欧姆型p-GaN栅极高电子迁移率晶体管的开关速度)。PPS由两个
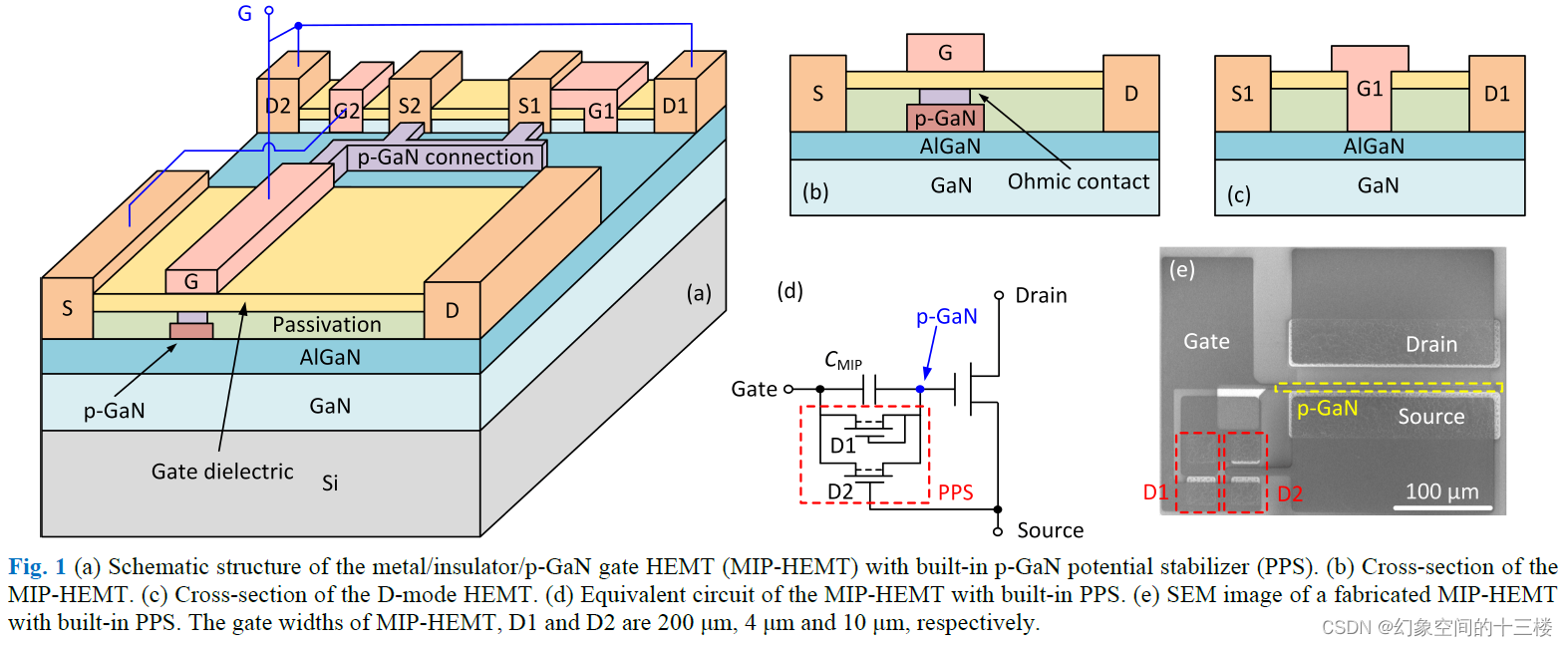
本工作中,首次证明了混合栅极技术在不增加额外面积和寄生效应的前提下,能有效提升p-GaN HEMTs的栅极静电放电(ESD)性能。通过部分替换p-GaN HEMT中的肖特基型栅极金属为欧姆接触型金属,制备了混合栅HEMT(Hyb-HEMT)。基于传输线脉冲(TLP)性能的对比研究,证实了Hyb-HEMT的栅极ESD承受能力提高了约11倍,表明由欧姆接触型金属引入的“放电路径”能有效耗散ESD能量。

摘要—在本文中,我们提出了一个基于物理的解析模型,用于描述AlGaN/GaN高电子迁移率晶体管中的二维电子气密度ns。所提出的模型考虑了费米能级Ef和ns之间的相互依赖关系。该模型通过考虑Ef、第一能带E0、第二能带E1以及ns随着栅极电压Vg的变化而进行了建模。所提出的模型与数值计算非常吻合。关键词—AlGaN/GaN高电子迁移率晶体管(HEMT),解析模型,二维电子气(2DEG)电荷密度。











