傻白入门芯片设计,芯片键合(Die Bonding)(四)
傻白入门芯片设计,芯片键合(Die Bonding)(四)引线键合、倒装芯片键合、管脚贴合技术
目录
四、管脚贴合技术(Tape Automated Bonding)
一、键合( Bonding)
作为半导体制造的后工序,封装工艺包含背面研磨(Back Grinding)、划片(Dicing)、芯片键合(Die Bonding)、引线键合(Wire Bonding)及成型(Molding)等步骤。这些工艺的顺序可根据封装技术的变化进行调整、相互结合或合并。芯片键合(die bonding)工艺可在划片工艺之后将从晶圆上切割的芯片黏贴在封装基板(引线框架或印刷电路板)上。
1. 什么是键合(Bonding)?
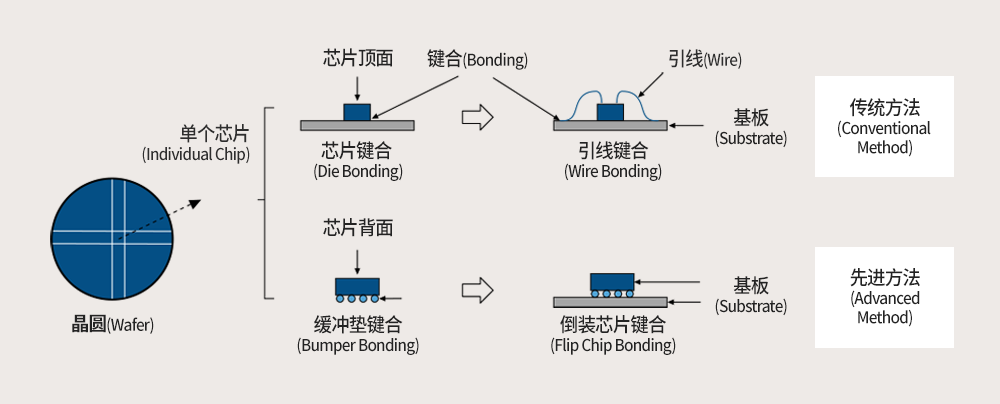
键合类型
在半导体工艺中,“键合”是指将晶圆芯片固定于基板上。键合工艺可分为传统方法和先进方法两种类型。传统方法采用芯片键合(Die Bonding)(或芯片贴装(Die Attach))和引线键合(Wire Bonding),而先进方法则采用IBM于60年代后期开发的倒装芯片键合(Flip Chip Bonding)技术。倒装芯片键合技术将芯片键合与引线键合相结合,并通过在芯片焊盘上形成凸块(Bump)的方式将芯片和基板连接起来。
就像发动机用于为汽车提供动力一样,芯片键合技术通过将半导体芯片附着到引线框架(Lead Frame)或印刷电路板(PCB, Printed Circuit Board)上,来实现芯片与外部之间的电连接。完成芯片键合之后,应确保芯片能够承受封装后产生的物理压力,并能够消散芯片工作期间产生的热量。必要时,必须保持恒定导电性或实现高水平的绝缘性。因此,随着芯片尺寸变得越来越小,键合技术变得越来越重要。
2. 芯片键合步骤

芯片键合与倒装芯片键合之间的比较
在芯片键合过程中,首先需在封装基板上点上粘合剂。接着,将芯片顶面朝上放置在基板上。与此相反,倒装芯片键合则是一种更加先进的技术,首先,将称为“焊球(Solder Ball)”的小凸块附着在芯片焊盘上。其次,将芯片顶面朝下放置在基板上。在这两种方法中,组装好的单元将经过一个被称为温度回流(Temperature Reflow)的通道,该通道可随着时间的推移调节温度,以熔化粘合剂或焊球。然后,在其冷却后将芯片(或凸块)固定到基板上。
3.芯片拾取与放置(Pick & Place)

芯片拾取和放置
逐个移除附着在切割胶带上数百个芯片的过程称为“拾取”。使用柱塞从晶圆上拾取合格芯片并将其放置在封装基板表面的过程称为“放置”。这两项任务合称为“拾取与放置”,均在固晶机(用于芯片键合的装置)上完成。完成对所有合格芯片的芯片键合之后,未移除的不合格芯片将留在切割胶带上,并在框架回收时全部丢弃。在这个过程中,将通过在映射表(用于设定合格和不合格芯片标准的软件)中输入晶圆测试结果(合格/不合格)的方式对合格芯片进行分类。
4. 芯片顶出(Ejection)工艺

芯片顶出工艺:在三个方向施加力时的放大图
完成划片工艺之后,芯片将被分割成独立模块并轻轻附着在切割胶带(Dicing Tape)上。此时,逐个拾取水平放置在切割胶带上的芯片并不容易。因为即使使用真空也很难轻易拾取芯片,如果强行拉出,则会对芯片造成物理损坏。
为此,可采用“顶出(Ejection)工艺”,通过顶出装置(用于从切割胶带下方顶起芯片的顶针)对目标芯片施加物理力,使其与其他芯片形成轻微步差,从而轻松拾取芯片。顶出芯片底部之后,可使用带有柱塞的真空吸拾器从上方拉出芯片。与此同时,使用真空吸拾器将切割胶带底部拉起,以使晶圆保持平整。
5. 使用环氧树脂(Epoxy)实现粘合的芯片键合工艺
在执行芯片键合时,可使用金或银(或镍)制成合金,特别是对于大型密封封装。也可通过使用焊料或含有金属的糊剂(Power Tr)进行连接,或使用聚合物-聚酰亚胺(Polymer, Polyimide)进行芯片键合。在高分子材料中,含银糊状或液体型环氧树脂(Epoxy)相对易于使用且使用频率较高。
使用环氧树脂进行芯片键合时,可将极少量环氧树脂精确地点在基板上。将芯片放置在基板上之后,通过回流(Reflow)或固化(Curing),在150°C至250°C的温度条件下使环氧树脂硬化,以将芯片和基板粘合在一起。此时,若所使用环氧树脂的厚度不恒定,则会因膨胀系数差异而导致翘曲(Warpage),从而引起弯曲或变形。因此,尽管使用少量环氧树脂较为有利,但只要使用环氧树脂就会发生不同形式的翘曲。
正因为如此,一种使用晶片黏结薄膜(Die Attach Film, DAF)的先进键合方法成为近年来的首选方法。尽管DAF具有价格昂贵且难以处理的缺点,但却易于掌握使用量,简化了工艺,因此使用率正在逐渐增加。
6. 使用晶片黏结薄膜(DAF)的芯片键合工艺

使用晶片黏结薄膜(DAF)的芯片键合工艺
DAF是一种附着在晶粒底部的薄膜。相比高分子材料,采用DAF可将厚度调整至非常小且恒定的程度。DAF不仅应用于芯片和基板之间的键合,还广泛应用于芯片与芯片之间的键合,从而形成多晶片封装(MCP)。换句话说,紧密粘合在芯片上的DAF等待切割工艺完成,然后在芯片键合过程中发挥自身的作用。
从切割芯片的结构来看,位于芯片底部的DAF支撑着芯片,而切割胶带则以弱粘合力牵拉着位于其下方的DAF。在这种结构中,要进行芯片键合,就需要在移除切割胶带上的芯片和DAF之后立即将晶粒放置在基板上,并且不得使用环氧树脂。由于在此过程中可跳过点胶工序,因此环氧树脂的利弊被忽略,取而代之的是DAF的利弊。
使用DAF时,部分空气会穿透薄膜,引起薄膜变形等问题。因此,对处理DAF的设备的精度要求格外高。尽管如此,DAF仍然是首选方法,因为它能够简化工艺并提高厚度均匀性,从而降低缺陷率并提高生产率。
用于放置芯片的基板类型(引线框架或印刷电路板)不同,执行芯片键合的方向也存在很大差异。很久以前,基于PCB的基板已经因其可应用于小尺寸批量生产封装而得到广泛使用。相应地,随着键合技术的日益多样化,用于烘干粘合剂的温度曲线(Temperature Profile)也在不断变化。其中一些具有代表性的键合方法包括加热粘接和超声波粘接。随着集成技术的不断提高,封装工艺继续朝着超薄方向发展,封装技术也变得多样化,比如——引线键合。
二、引线键合(Wire Bonding)
结束前工序的每一个晶圆上,都连接着500~1200个芯片(也可称作Die)。为了将这些芯片用于所需之处,需要将晶圆切割(Dicing)成单独的芯片后,再与外部进行连接、通电。此时,连接电线(电信号的传输路径)的方法被称为引线键合(Wire Bonding)。其实,使用金属引线连接电路的方法已是非常传统的方法了,现在已经越来越少用了。近来,加装芯片键合(Flip Chip Bonding)和硅穿孔(Through Silicon Via,简称TSV)正在成为新的主流。加装芯片键合也被称作凸点键合(Bump Bonding),是利用锡球(Solder Ball)小凸点进行键合的方法。硅穿孔则是一种更先进的方法。

键合法发展史:引线键合(Wire Bonding)→加装芯片键合(Flip Chip Bonding)→硅穿孔(TSV)
为使半导体芯片在各个领域正常运作,必须从外部提供偏压(Bias voltage)和输入。因此,需要将金属引线和芯片焊盘连接起来。早期,人们通过焊接的方法把金属引线连接到芯片焊盘上。从1965年至今,这种连接方法从引线键合(Wire Bonding),到加装芯片键合(Flip Chip Bonding),再到TSV,经历了多种不同的发展方式。引线键合顾名思义,是利用金属引线进行连接的方法;加装芯片键合则是利用凸点(bump)代替了金属引线,从而增加了引线连接的柔韧性;TSV作为一种全新的方法,通过数百个孔使上下芯片与印刷电路板(Printed Circuit Board,简称PCB)相连。

引线键合的结构(载体为印刷电路板(PCB)时)
引线键合是把金属引线连接到焊盘上的一种方法,即是把内外部的芯片连接起来的一种技术。从结构上看,金属引线在芯片的焊盘(一次键合)和载体焊盘(二次键合)之间充当着桥梁的作用。早期,引线框架(lead frame)被用作载体基板,但随着技术的日新月异,现在则越来越多地使用PCB作基板。连接两个独立焊盘的引线键合,其引线的材质、键合条件、键合位置(除连接芯片和基板外,还连接两个芯片,或两个基板)等都有很大的不同。
详细地引线键合技术参见:
引线键合(Wire Bonding)——将芯片装配到PCB上的方法 | SK hynix Newsroom
三、倒装芯片键合(Flip Chip)
芯片倒装的英文名称叫Flip Chip,就是让芯片的接触点与基板、载体、电路板相连,在相连的过程中,由于芯片的凸点是朝下连接,因此称为倒装。
倒装也是和普通元器件朝上放置相比较而言的,也称为DCA(Direct chip attach).倒装芯片的示意图如下:
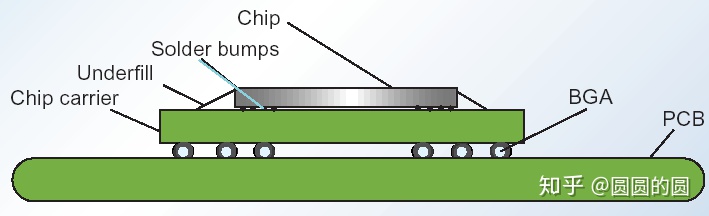
在典型的倒装芯片封装中, 芯片通过3到5个密耳(mil)厚的焊料凸点连接到芯片载体上,底部填充材料用来保护焊料凸点,上图中芯片Chip和PCB板通过倒装技术连接在一起。
日常中常见到了电子元器件很多都采用了倒装焊接技术,比如我们电脑中的内存条:

如果将内存条从截面剖开,芯片与电路板便是采用的倒装连接技术。
倒装芯片键合的具体步骤:

芯片倒装技术中的芯片通常有一面有凸点,另一面是光滑的。芯片的凸点通常是用于连接到基板、载体或电路板上的,而光滑的一面通常是用于填充芯片的背面的。在芯片倒装的过程中,芯片的凸点与基板接触,从而实现芯片与基板之间的连接。芯片倒装可以实现芯片密度更高的封装,并且可以提高系统的信号传输速度和可靠性。缺点是:
- 制造过程复杂,生产成本较高。
- 芯片与基板之间的连接不够稳定,容易断路。
四、管脚贴合技术(Tape Automated Bonding)
管脚贴合技术是指在制造电子元器件时,用于将管脚(也称为焊盘)焊接到电路板上的技术。管脚贴合通常用于焊接大型元器件,如芯片、电阻器、电容器等。
在管脚贴合过程中,元器件的管脚被焊接到电路板上的焊点上(将金丝转换成铜箔,铜箔与芯片管脚的凸点贴合,称为TAB)。这种方法通常使用机械臂将元器件移动到焊接位置,然后使用电子焊接设备将管脚焊接到电路板上。管脚贴合可以使用多种焊接技术,如点焊、带弧焊、压焊等。
管脚贴合技术与倒装芯片键合技术有一些相似之处,但是倒装芯片键合技术通常用于焊接小型元器件,而管脚贴合技术则通常用于焊接大型元器件。

五、总结
在实际应用中,引线键合和倒装芯片技术是常用的MCM封装技术(多个芯片封装在一个有机基板上),因为它们可以实现高密度的芯片连接,并且具有较好的可靠性。
-
引线键合是一种用于焊接电子元器件的常见方法。在引线键合过程中,电子元器件的引线(也称为焊盘)被焊接到电路板上的焊点上。这种方法通常用于焊接大型元器件,如芯片、电阻器、电容器等。
-
倒装芯片键合是一种焊接小型元器件的方法。在倒装芯片键合过程中,元器件被焊接到倒装焊盘上,然后倒装焊盘被焊接到电路板上。这种方法通常用于焊接芯片或其他小型元器件,如晶体管、二极管等。
总的来说,引线键合和倒装芯片技术是常用的MCM封装技术,可以实现高密度的芯片连接,并具有较好的可靠性。引线键合与框架封装一般用于I/O数目较少、对信号速率要求较低的情况,而倒装芯片技术可以支持更高的信号速率、更短的信号传输路径。
参考资料:
切单(Singulation),一个晶圆被分割成 多个半导体芯片的工艺 | SK hynix Newsroom
将芯片固定于封装基板上的工艺——芯片键合(Die Bonding) | SK hynix Newsroom
更多推荐
 已为社区贡献3条内容
已为社区贡献3条内容










所有评论(0)